台积电,转战1.4nm
报道进一步指出,台积电日前敲定于今年8月于竹科研发中心P8厂及南科18B的P5厂,南北同时启动3纳米量产后,接下来要在先进制程开发上压制英特尔藉由2纳米技术突破争食苹果新世代处理器的威胁,以持续在晶圆代工保持领先优势。
考虑到三星和英特尔都对台积电嘴边的蛋糕虎视眈眈。毫无疑问,又一轮芯片制程大赛即将打响。
台积电急了
在之前的财报会上,台积电联席总裁魏哲家曾经表示,公司的2nm工艺正在研发当中,如按照初步规划,试产将在2024年底,最快则将于2025年投入量产。但是,英特尔在更早之前曾经表示,公司将在今年下半年完成Intel 18A(约为1.8nm )的芯片设计,并将原定的量产时间从之前的2025年提前到2024年。由此,我们可以看到台积电担忧的来源。
另一个方面,对工艺制程有了解的读者应该知道,今年下半年开战的3nm工艺推进到现在,其实基本面已经定了。因为三大厂商(台积电、英特尔和三星)的工艺进度,甚至客户在目前看来都初步确定,且短期有太大的变化的可能性比较小。
但在3nm后的技术节点,则又有新的不确定性。
众所周知,自2011年英特尔发布22nm工艺以来,包括Intel、台积电、三星、格芯和中芯国际都几乎在所有的先进工艺逻辑芯片上使用FinFET晶体管制造。和以前的平面晶体管沟道是水平的不一样。在 FinFET 中,沟道是垂直的,栅极环绕在沟道周围,能从沟道的三个侧面提供出色的控制。
正因为这种不同寻常的设计,FinFET在应用中带来了更多的优势。例如对于给定的晶体管占位面积有更高的驱动电流、更高的速度和更低的泄漏,这使其能够具备更低的功耗、无随机掺杂剂波动,使得晶体管具有更好的迁移率和缩放比例。借助这个创新的晶体管设计,芯片制造工艺演进到了今年下半年面世的3nm。因为除了三星以外,其他晶圆代工厂在这个节点依然使用的是FinFET。
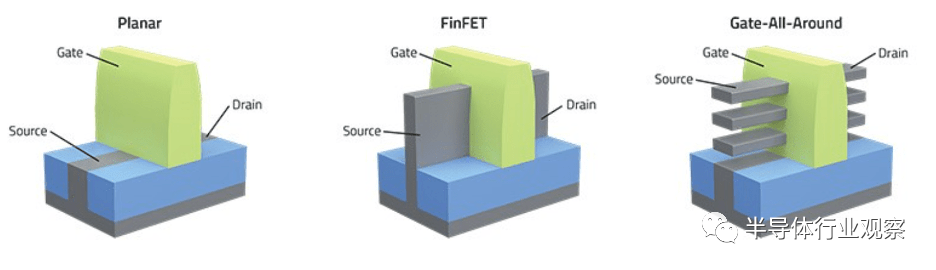
然而,到了3nm以后的工艺,FinFET的历史使命就已经完成了,这就驱使所有晶圆代工厂就不得不探索新的制造方法,如三星在3nm上应用的GAA(Gate All Around)晶体管就是当中一个选择。和当初从平面往立体转一样,新的晶体管也会给开发者提出新挑战。需要提示一下的是,三星在3nm就用上了这种新型晶体管,而英特尔也披露了不少关于他们新晶体管的信息,他们更是把Intel 18A看作超越台积电的关键技术。再加上,近日日经新闻报道,美国和日本正计划在2nm芯片上合作。考虑到日本在设备上的领先、当前的芯片本地制造趋势、美国IBM过往在先进工艺上的辉煌历史、热潮他们也于一年前推出2nm芯片等多种因素。
这就让在新工艺保密工作做得非常之好的台积电急了。
GAA没那么简单
如上所说,GAA晶体管是行业必然的发展趋势,而纳米片就是GAA晶体管的首个选择。
所谓纳米片,从构造上看,纳米片FET是一种旋转90度的finFET,这就让其可以产生水平堆叠的fin,而每个fin中间都有垂直栅极材料,且每个fin都是一个沟道。
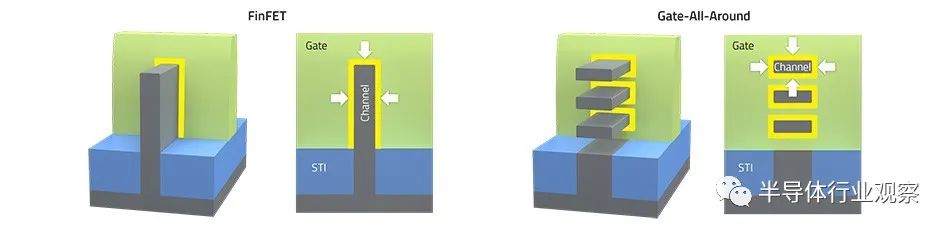
Lam Research在其2020年的一篇博客中介绍道,早期的GAA设备将使用垂直堆叠的纳米片。它们由单独的水平片构成,四周都被门材料包围。这提供了相对于finFET改进的通道控制。与更高电流需要多个并排fin的FinFET不同,GAA 晶体管的载流能力通过垂直堆叠几个纳米片来增加,栅极材料包裹在通道周围。纳米片的尺寸可以缩放,以便晶体管的尺寸可以满足所需的特定性能。
该篇博客文章进一步指出,纳米片在概念上可能很简单,但它们对制造提出了新的挑战。其中一些挑战围绕着制造结构,其他涉及实现 PPAC 扩展目标所需的新材料。
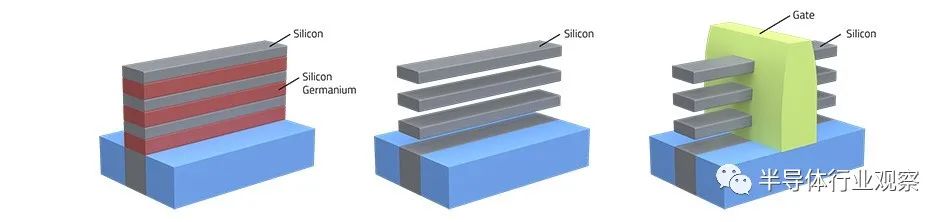
如图所示,GAA晶体管是通过首先生长交替的Si和SiGe外延层的超晶格来制造的,这些外延层构成了纳米片的基础。而其关键步骤则包括沉积内部电介质间隔物以保护源极/漏极区域并定义栅极宽度,以及用于去除牺牲层(sacrificial layer)的沟道释放蚀刻。去除牺牲层后留下的空间需要用栅极电介质和金属填充,包括纳米片之间。因为栅极金属很可能会引入新材料,为此一些制造商正在评估钴,钌、钼、镍和各种合金。
在semiengineering的报道中,他们也揭露了制造纳米片FET带来的重大挑战。
首先在流程中,外延工具在衬底上沉积超薄、交替的SiGe和硅层,形成超晶格结构。这种结构可能具有三层、五层或更多层的每种材料;其次,微小的垂直fin在超晶格结构中被图案化和蚀刻。然后,形成内间隔物。在间隔蚀刻中,超晶格结构中的SiGe层的外部部分被凹陷,然后用介电材料填充;第三,形成源极/漏极。然后,去除超晶格结构中的SiGe层,留下构成通道的硅基层或片;最后,通过沉积高k电介质和金属栅极材料形成栅极。

”以上每一步都是一个挑战。与所有工艺一样,目标是开发没有缺陷的芯片。这需要在晶圆厂中采用完善的工艺控制策略。”semiengineering的记者在文章中强调。(关于纳米片制造,请参考半导体行业观察的文章《FinFET的继任者:纳米片该如何制造?》)
台积电制造集成经理在今年二月接受IEEE采访的时候就首先强调,我们正在接近原子尺度。然后他继续说:“以前,我们可以通过微调工艺来实现下一代节点,但现在每一代我们都必须在晶体管架构、材料、工艺和工具方面找到新的方法。在过去,这几乎是一种主要的光学缩小,但这不再是一个简单的技巧。”
Lam Research方面则表示,GAA晶体管将成为FinFET的继任者,而纳米片将演变为纳米线。这些GAA结构应该贯穿当前路线图上的高级流程节点。
上一篇:梅西好友斥责皮克假惺惺:你不但没哭还反插一
下一篇:南京世和基因生物技术股份有限公司拟IPO