重复性缺陷的筛选方法与流程
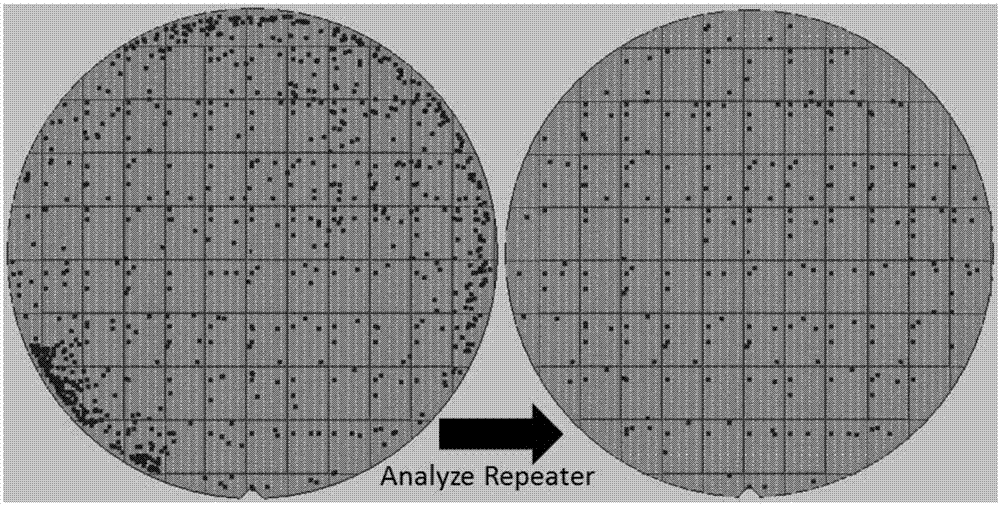
本发明涉及半导体集成电路制造技术领域,尤其涉及一种重复性缺陷的筛选方法。
背景技术:
随着超大规模集成电路ulsi(ultralargescaleintegration)的飞速发展,集成电路工艺制作工艺变得越来越复杂和精细,这就要求以更高的精度和更好的均匀性形成半导体器件,而在实际集成电路生产过程,由于工艺和设备等不同因素的影响,往往在衬底表面会形成不可预期的缺陷,例如,颗粒缺陷,最终导致产品良率的降低,因此,在集成电路生产中半导体衬底的缺陷检测也变得至关重要。
在半导体制造过程中,在晶圆上一些晶粒上出现低良率问题,这些低良率问题是有规律的,被称为“重复性缺陷”,且目前能够确定这些重复性缺陷是晶圆制造过程中的光罩引起的。因此,需要对重复性缺陷进行检测。目前,对缺陷扫描所得到的缺陷位置分布图作重复性缺陷筛选是缺陷检测中判断光罩引入缺陷的重要手段和依据。该方法通过比对缺陷位置分布图上的缺陷是否存在以光罩为单元的重复性从而筛选出光罩异常导致的缺陷,再通过扫描电镜复检获取图像,最后根据筛选出的缺陷图像数据分析缺陷情况。
在生产过程中,如果掩模版缺陷检测机发现光罩上存在缺陷风险,除了对光罩进行缺陷扫描外,通常还会再在晶圆上确认实际曝光的缺陷情况。为了能够检测出晶圆上实际的光阻图形缺陷情况,需要采用比较严格的扫描条件来检测晶圆上的缺陷,而严格的扫描条件在能够扫描出潜在的重复性缺陷的同时,还会引入很多nuisance(非真实缺陷的缺陷扫描结果),其中包括机台扫描本身引入的噪声、特定工艺层引入的缺陷和特定图形引入的噪声等。通过以光罩为单元做重复性缺陷计算并筛选可以得到包含潜在光罩引入缺陷的缺陷合集,由于该缺陷合集还包括上述nuisance,通常筛选后的合集中缺陷数目远高于实际水平。要发现包含于晶圆中光罩引入缺陷不但会耗费大量的检测机台产能而且存在随机检测带来的漏检风险,从而对光罩上可能存在的缺陷评估造成影响,并影响产品的最终良率。
技术实现要素:
本发明的目的在于提供一种重复性缺陷的筛选方法,解决现有技术中重复性缺陷检测效率低、漏检的技术问题。
为解决上述技术问题,本发明提供一种重复性缺陷的筛选方法,包括:
获取晶圆的缺陷分布数据;
以晶粒为重复单元,计算出缺陷的第一重复性合集及其在晶粒中的坐标;
以光罩为重复单元,计算出缺陷的第二重复性合集,并计算第二重复性合集中各缺陷对应于以晶粒为重复单元的坐标;
匹配第二重复性合集中各缺陷以晶粒重复单元的坐标与第一重复性合集中各缺陷的坐标,计算坐标相同的缺陷在各自重复性合集中重复的次数,并计算两次数的差值与第二重复性合集中次数的比值k;
如果k等于零或小于设定阈值k0,则确认该缺陷为重复性缺陷。
可选的,所述第一重复性合集包括缺陷的编号、缺陷在晶粒中的坐标及重复的次数。
可选的,所述第二重复性合集包括缺陷的编号、缺陷在光罩中的坐标及重复的次数。
可选的,所述缺陷分布数据包括缺陷的编号、缺陷在晶圆中的坐标、晶粒的单元尺寸、光罩的规格。
可选的,通过一缺陷检测设备获取所述晶圆上所有缺陷的位置,通过所述缺陷检测设备将所述缺陷坐标进行存储。
可选的,获取晶圆缺陷的位置的步骤包括:
通过所述缺陷检测设备对晶圆进行检测,以获取晶圆上每个晶粒的检测数据;
将晶圆上的每个晶粒的检测数据与之前相邻的一个晶粒的检测数据进行比较,获得若干第一差异位置;
将晶圆上的每个晶粒的检测数据与之后相邻的一个晶粒的检测数据进行比较,获得若干第二差异位置;
若晶粒所对应的第一差异位置与其对应的所述第二差异位置相同,则将该第一差异位置或第二差异位置设置为该晶粒上缺陷的位置。
可选的,所述光罩的规格为1mm×1mm。
可选的,k0为大于0小于1之间的数。
可选的,k0为0.01~0.05之间的数。
与现有技术相比,本发明提供的重复性缺陷的筛选方法具有以下有益效果:
本发明的重复性缺陷检测方法中,分别以晶粒和光罩为重复单元,建立第一重复性合集和第二重复性合集,计算第二重复性合集中的各缺陷对应于其在以晶粒为重复单元中的坐标,将该坐标与第一重复性合集中缺陷的坐标进行匹配,若坐标相同,则分别计算对应的缺陷在各自重复性合集中重复的次数,根据次数计算出比值k,若k等于0或小于设定阈值k0,则该缺陷为重复性缺陷。本发明中,能够提高筛选所得到的光罩引入缺陷信息的准确率,从而降低漏检风险,提升良率。
附图说明
图1为本发明一实施例中重复性缺陷检测方法的流程图;
图2为现有技术中重复性缺陷的检测结果;
图3为本发明中重复性缺陷的检测结果。
具体实施方式
上一篇:阿特拉斯FD冷冻式干燥机
下一篇:1130家企業入選新經濟梯度培育名單